封装旧芯片翻新SOP芯片拆卸,BGA植球封装旧芯片翻新
QFN芯片脱锡加工是指在表面贴装技术中,将QFN封装芯片上的锡膏除去的过程。脱锡加工是PCB制造过程中的一个重要环节,它可以保障芯片与PCB板之间的连接质量,避免因锡膏残留导致的焊接不良或短路等问题。
脱锡加工通常包括以下步骤:
1. 热风吹除:通过热风气流将QFN芯片上的锡膏加热融化,并吹除;
2. 真空吸除:利用真空吸力将融化的锡膏吸走;
3. 清洗处理:利用化学溶剂或超声波清洗,将残留在芯片上的锡膏除去。
脱锡加工的关键是控制加热温度、吹除气流和清洗方法,要确保脱锡过程既能有效去除锡膏,又不会对芯片和PCB造成损害。同时,应严格遵循脱锡操作流程,确保产品质量和生产效率。
深圳市卓汇芯科技有限公司是一家从事电子元器件配套加工业务的企业,主营业务有:BGA植球, QFN除锡,QFP除锡 , IC研磨刻字、 IC激光烧面、 IC盖面刻字、 IC编带抽真空 、IC拆板翻新、 等。保护知识产权,防止技术泄密。可加工各种封装的IC:BGA/ OFN/ DIP/ DDR/ EMMC/ EMCP/ SSD/ SOP/ SSOP/ SOT/ TO/ PLCC系列以及各种不规则封装。
全程用料环保,防静电处理,客户信息高度保密。本公司以高素质的人才,多年的芯片加工经验及率、高精细的加工设备,竭诚为广大客户提供的服务!
公司经营宗旨:品质、客户至上!欢迎各位新老客户前来我司实地考察指导!
我们的服务:承接:BGA CPU QFN QFP SOP TSOP CCM玻璃芯片
烘烤除湿,拆卸,除锡,除氧化,植球,清
洗,修脚,压脚,磨面,面盖,打字,编带等工
艺
SMT贴片炉后BGA返修焊接,换料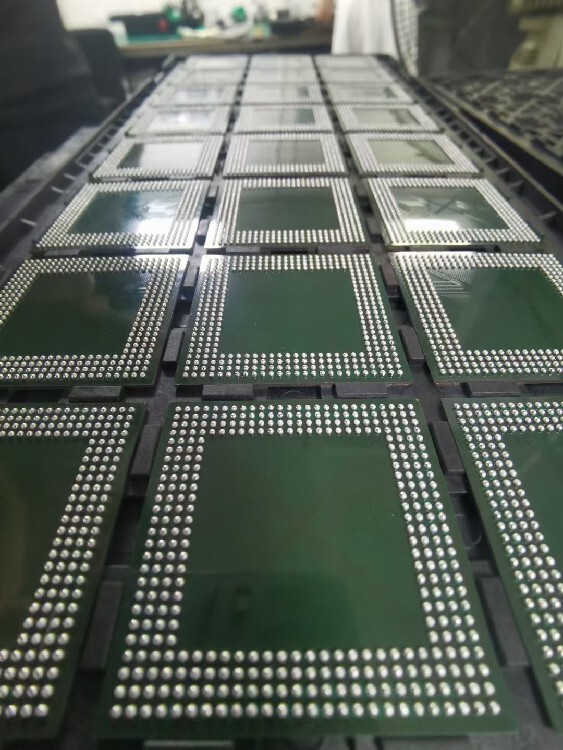
1. 熟悉BGA返修流程:在进行BGA返修前,需要对整个返修流程有一个清晰的了解,包括准备工具材料、设备调试、返修操作步骤等。
2. 选择合适的返修工具:在进行BGA返修时,需要选择适合的返修工具,比如BGA热风枪、返修站、烙铁等。同时还要根据具体情况选择合适的返修材料,如焊锡丝、助焊剂等。
3. 控制温度和时间:在进行BGA返修时,需要严格控制热风枪的温度和返修时间,以避免过热或过烫导致焊点受损,影响BGA的连接质量。
4. 注意防静电:在进行BGA返修时,需要注意防静电,确保操作环境和操作人员不会对BGA元件造成静电损坏。
5. 检查返修效果:在完成BGA返修后,需要进行仔细的检查,确保焊点连接牢固、没有缺陷,并且BGA元件安装正确。如果有需要,还可以进行功能测试以验证返修效果。
6. 注意安全:在进行BGA返修时,需要注意安全,避免因操作不当导致意外事故发生。同时,要根据返修设备的要求使用个人防护装备,确保操作人员的安全。



