TSV小型晶圆喷镀台医疗,晶圆电镀台
1/4
- 面议
- 2024-09-28 01:03:01
- TSV小型晶圆喷镀台,晶圆电镀机,晶圆喷镀..
- 徐发杰 18515625676
- 北京汐源科技有限公司
信息介绍
详细参数
在电沉积⼯艺之前,对 TSV 芯片进⾏预处理以排除通孔中的
空⽓并润湿种⼦层。,将 TSV 芯片放⼊吸瓶中并浸⼊去
离⼦⽔中。然后,使用⽔循环泵将抽吸瓶抽空⾄负⽓氛。在
负压下,通孔中的空⽓被推⼊样品片表面。此外,应用间歇
性超声振动去除表面⽓泡,直⾄⽆⽓泡出现,表明预处理完
成。因此,TSV芯片迅速移动到电镀槽中并保持静⽌⾜够长
的时间以确保电镀溶液在通孔内充分扩散。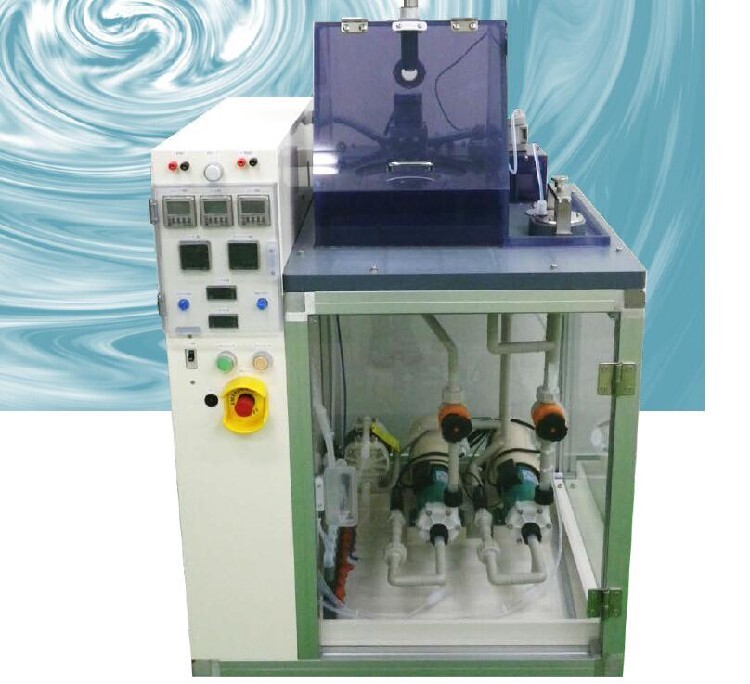
玻璃通孔⾼密度布线
线路转移(CTT)和光敏介质嵌⼊法,是比较常用的⽅式。 CTT主要 包括两个过
程。⼀是精细RDL线预制,每⼀RDL层可以在可移动载体上单 制造⼀层薄导
电层,并在转移到基板上之前测试或检查细线成品率。精 细线路的形成采用细
线光刻和电解镀铜的⽅法,并且以薄铜箔作为镀层的 种⼦层
嵌⼊式玻璃扇出与集成天线封装
玻璃通孔还可以在玻璃上制作空腔,进⽽为芯片的封装提供⼀种嵌⼊ 式玻璃扇
出(eGFO)的新⽅案。2017年乔治亚理⼯率先实现了用于⾼I/O 密度和⾼频多芯
片集成的玻璃面板扇出封装。该技术在70um厚、⼤小为 300mm*300mm的玻璃
面板上完成了26个芯片的扇出封装,并有效的控 制芯片的偏移和翘曲。2020年
云天半导体采用嵌⼊式玻璃扇出技术开了 77GHz汽⻋雷达芯片的封装,并在此
基础上提出了⼀种⾼性能的天线封装 (AiP)⽅案。
- TSV小型晶圆喷镀台,晶圆电镀机,晶圆喷镀..
- 蚀刻机
- 徐发杰
北京汐源科技有限公司为你提供的“TSV小型晶圆喷镀台医疗,晶圆电镀台”详细介绍