有压烧结银加压烧结银膏烧结银研发
1/6
- ¥89000.00
- 2024-07-07 07:58:30
- 金属类
- 有压烧结银膏,纳米烧结银膏,有压烧结银,..
- 北京
- 刘志 13611616628
- 善仁(浙江)新材料科技有限公司
信息介绍
详细参数
有压烧结银是一种常见的半导体封装材料,压烧结银的工艺非常复杂,需要考虑到不同的因素,如热量、熔融银的温度、模具的造型等。这种工艺需要熟练的技艺,可以制作出精美的饰品。
基于以上两款焊料的不足,烧结银产品应运而生,烧结银克服了以上两款产品的各种不足和问题,具有导热系数高,剪切强度大,生产,无铅化、免清洗等特点,是第三代半导体封装的理想焊接材料。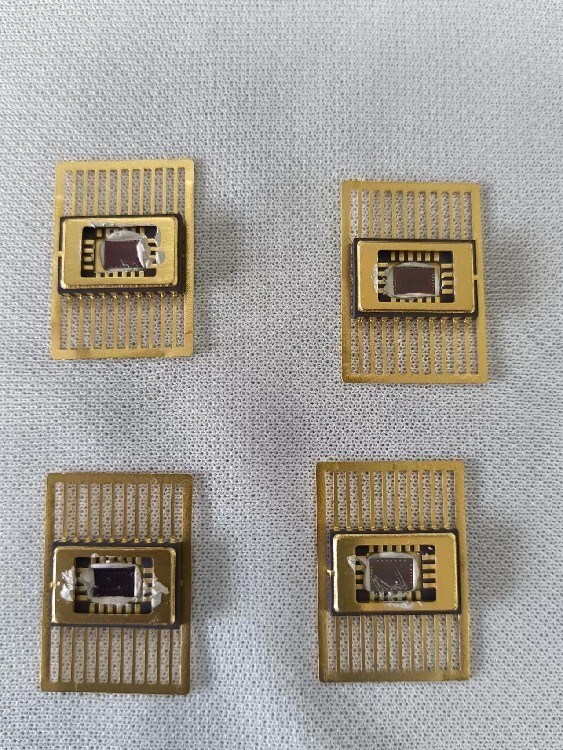
有压烧结银对于一些功率器件的封装来说是非常的有效的。同时,这个烧结可以用在比较要规模的封装之上。银烧结可以用到我们的功率元件和一些LED方面,比如激光器件也会用烧结银。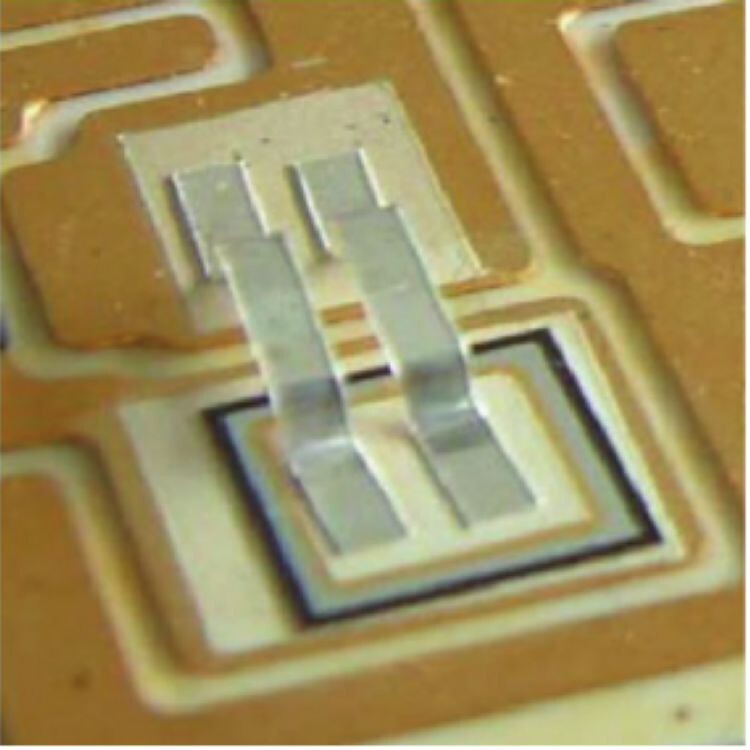
预压阶段:150度加压0.5-1MPa,时间为:1-3秒; 本压阶段:220-280度加压10-30MPa,时间2-6分钟;烧结结束时,建议在烘箱中逐步降温到室温再把器件拿出。
善仁新材研究院在烧结银块体的性能研究发现:随烧结温度升高和压力加大,烧结体密度和硬度逐渐增大,尤其在分散剂的分解温度和原子扩散重排温度区间,增大的趋势更加明显;
与此同时,烧结温度越高,烧结银块体的热导率也跟着增大,280℃烧结银的热导率已达到266W/(m·K)。
- 有压烧结银膏,纳米烧结银膏,有压烧结银,..
- 导电银胶
- 北京
- 刘志
- 金属类
善仁(浙江)新材料科技有限公司为你提供的“有压烧结银加压烧结银膏烧结银研发”详细介绍