善仁纳米烧结银膏,杭州定制善仁纳米烧结银服务周到
1/6
- ¥199000.00
- 2024-10-23 01:32:01
- 纳米烧结银,纳米烧结银膏
- 刘志 13611616628
- 善仁(浙江)新材料科技有限公司
信息介绍
详细参数
善仁新材复合纳米银膏烧结体导热性能的研究
在电子领域,用于连接芯片和散热基板,降低其接触热阻并提高器件散热性能的材料被称为热界面材料。近年来第三代半导体技术的飞速发展给热界面材料的性能带来了的挑战: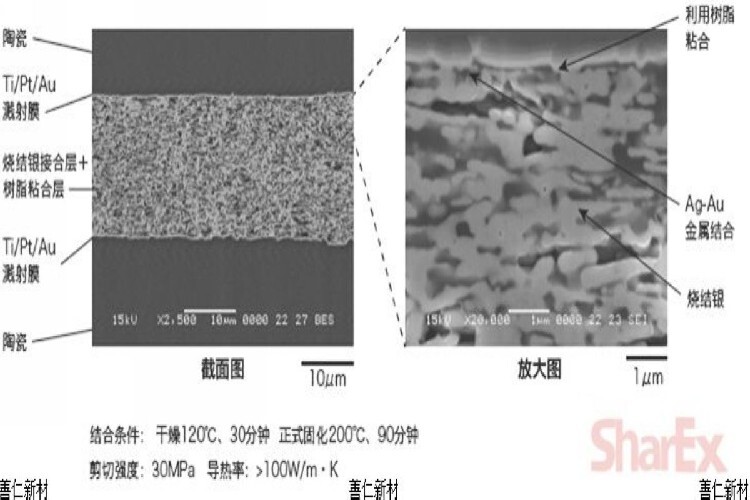
一方面,第三代半导体材料自身的热导率已经非常,比如碳化硅热导率可以达到83.6Wm-1K-1,这对热界面材料的导热性能提出了较高要求。如果热界面材料热导率过低就会在连接界面处聚集大量热量,从而降低互连结构的可靠性;另一方面,碳化硅等第三代半导体功率器件的工作温度可以达到260℃甚至更高,传统热界面材料的服役温度上限,这对热界面材料的高温服役可靠性提出了较高要求。
一是复合纳米银烧结体与其它单一尺寸纳米银烧结体相比,其孔隙率始终保持低(在室温至270℃的烧结温度范围内孔隙率基本保持在13.5%左右);二是复合纳米烧结银烧结体晶粒尺寸在烧结温度130℃后,始终大于其它单一尺寸纳米银膏(烧结温度为270℃的复合纳米银膏烧结体的平均晶粒尺寸为56.8nm);三是复合纳米银膏烧结体中存在大量的共格孪晶,孪晶界有利于提高烧结体导热性能。
- 纳米烧结银,纳米烧结银膏
- 导电银胶
- 刘志
善仁(浙江)新材料科技有限公司为你提供的“善仁纳米烧结银膏,杭州定制善仁纳米烧结银服务周到”详细介绍