善仁功率器件烧结银膏,常州半导体器件低温烧结银报价
1/6
- ¥198000.00
- 2025-02-21 02:27:09
- 大功率器件低温纳米烧结银,功率器件烧结..
- 刘志 13611616628
- 善仁(浙江)新材料科技有限公司
信息介绍
详细参数
在如上所述的电子零器件的小型化、高功能化的进展中,半导体元件的发热量具有增大的倾向。然而,若电子零器件长时间暴露在高温环境下,则寿命急剧减少。因此,对于芯片粘接材料散热的要求越来越高。
为此,国内外各大公司都开始研发低温烧结银。其原理是将银烧结到一起,提供导热通路,得到高导热系数。目前市场上广泛使用的导电银品牌包括善仁新材,SHAREX,ALWAYSTONE,京瓷等。
善仁新材烧结银烧结一般可以分为初期、中期和后期,它们之间没有明显界限。
烧结初期,颗粒在烧结驱动力的作用下会进行一定的重排,增加接触面积,生成烧结颈(necks),烧结初期一直持续到烧结颈的直径达到颗粒直径的0.4~0.5倍。
终阶段时孔洞变得不稳定,相互融合产生更大孔洞。多晶材料中的烧结机理,只有晶界处和烧结颈的缺陷处的体积扩散(volume diffusion)才能产生致密化。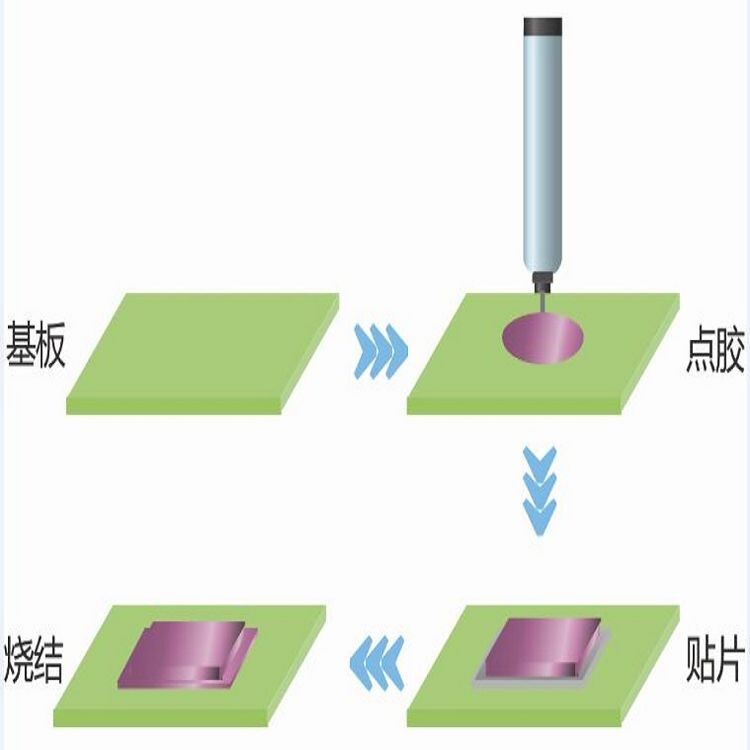
善仁新材开发的烧结银技术被定位为继焊料之后的次世代接合技术,由于比焊料更能耐受高温,具有的散热性,可望适用于电动车(EV)、碳化硅(SiC)功率半导体等用途。但相对于焊料在回焊(Reflow)时可快速接合,很多国外的烧结银则须利用装置进行加压制程,因此有生产效率的问题,且加压装置会增加投资成本。
善仁新材开发的AS9375功率器件烧结银胶能适用于无加压的低温烧结,具有使用上的便利性。且即使是在无加压的氮气氛围下进行烧结,亦能发挥的接合强度与导电率。
- 大功率器件低温纳米烧结银,功率器件烧结..
- 导电银胶
- 刘志
善仁(浙江)新材料科技有限公司为你提供的“善仁功率器件烧结银膏,常州半导体器件低温烧结银报价”详细介绍