青岛定制善仁SiC碳化硅烧结银膏性能可靠
1/6
- ¥1900.00
- 2025-03-03 04:07:02
- 金属类
- SiC碳化硅烧结银膏,宽禁带半导体烧结银,S..
- 刘志 13611616628
- 善仁(浙江)新材料科技有限公司
信息介绍
详细参数
由于现有封装技术的限制,特别是芯片与基板的互连技术,例如银浆、聚合物材料,软钎焊等互连技术由于焊料合金的低熔点、环氧树脂的低温分解等原因,使其不能在高温环境下可靠工作,导致限制电力电子系统性能和可靠性的瓶颈从半导体芯片转移到了封装技术上来。
另外,善仁新材研究院发现:较大面积的互连会导致较差的互连质量,其原因是增加的互连面积阻止了有机成分被燃尽,会导致更高的的孔隙率,针对这种现象,善仁新材提出了两个解决方案: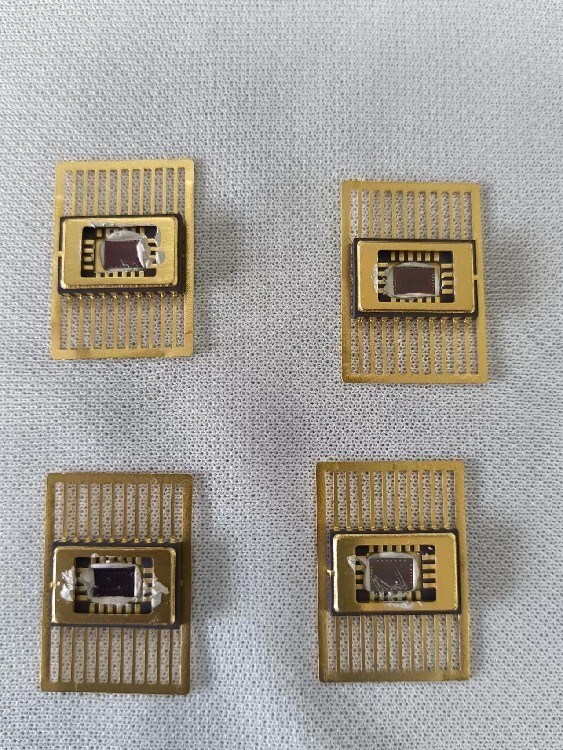
随着全球无铅化的推进,善仁新材的纳米烧结银时替代焊锡膏作为连接材料的候选材料之一,特别是在混动和电动汽车,高铁,航空航天,太阳能,深井石油开采等需要在200度恶劣环境下的各种工作应用,必将成为主流的互连材料之一。
- SiC碳化硅烧结银膏,宽禁带半导体烧结银,S..
- 导电银胶
- 刘志
- 金属类
善仁(浙江)新材料科技有限公司为你提供的“青岛定制善仁SiC碳化硅烧结银膏性能可靠”详细介绍