上海出售晶圆扶梯规格型号
- 面议
- 2025-02-10 04:00:43
- 晶圆扶梯,晶圆扶梯,晶圆读号器,晶圆查看器
- 张先生 15962404138
- 苏州硕世微电子有限公司
信息介绍
详细参数
位移是物体在运动过程中位置变化,它与移动量有关。小位移通常用应变式、涡流式、差动变压器式、电感式、霍尔传感器来检测,大位移常用感应同步器、光栅、容栅、磁栅等传感技术来测量。本文采用测量直线位移量的传感器,具体有电感式位移传感器、电容式位移传感器、光电式位移传感器、超声波位移传感器、霍尔式位移传感器。
晶圆上表面有定位用的标识,晶圆在预对准阶段确定好了与传输机械手的相对位置,经过升降机构到达工件台吸盘上,为了检测标识位需要其与吸盘相对位置是固定的。因此要求升降机构在圆周方向上不存在转动。同时光栅传感器安装要求光栅尺与读数头相对位置在+0.1mm。防转装置能机构运动圆周方向相对位置,晶圆传输的精度。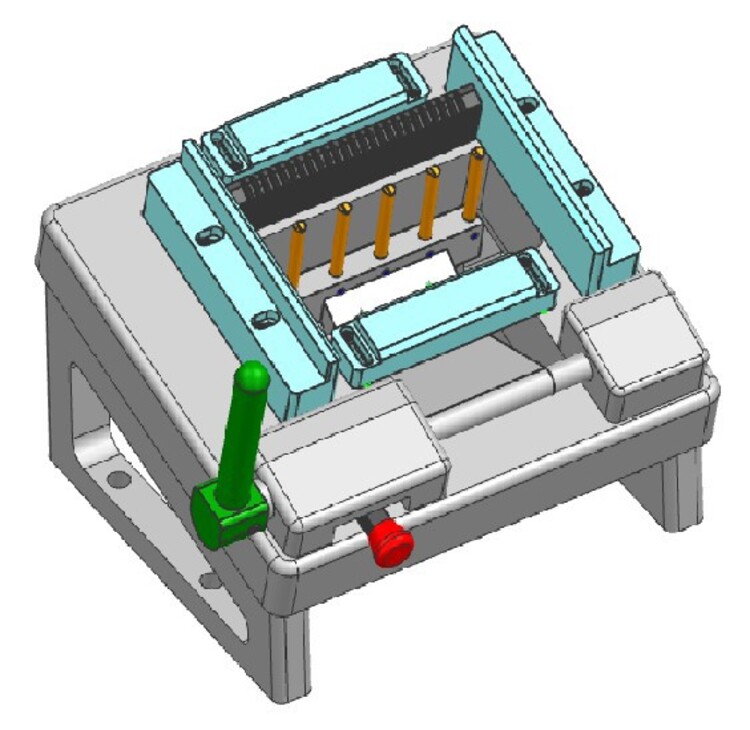
晶圆升降系统是半导体制造中重要的工艺设备之一,常规的晶圆升降系统通常有两种:其中一种晶圆升降系统包括:顶针、静电吸盘、组合支架及三个升降气缸,所述顶针通过所述组合支架固定在所述升降气缸上,当所述顶针托载晶圆时,所述升降气缸可以控制组合支架及托载晶圆的所述顶针相对静电吸盘上升或者下降一定的高度。但是,当组合支架使用时间过长时容易损坏,导致顶针,下降的高度不够,使得顶针与晶圆的背面的间距过小,进而导致晶圆上累积的电荷在该顶针区域局部放电起辉造成放电,从而导致晶圆良率损失。
另一种晶圆升降系统包括三个顶针、静电吸盘及三个升降气缸,一个升降气缸控制一个顶针的升降,采用该装置进行晶圆升降时发现,由于顶针的上升受升降气缸压力波动的影响,导致三个顶针的下降高度存在差异,使得其中某个顶针与晶圆的背面的间距过小,进而导致晶圆上累积的电荷在该顶针区域局部放电起辉造成放电,从而导致晶圆良率损失。
目前,半导体制程设备中,常常需要用电机通过传动带带动滚珠丝杆,来控制晶圆的升降。而传动带通过摩擦来传递动力,因此传动带要调整张紧力以获得合适的摩擦力。通过调整传动带的张紧度可以调整传动带和齿轮之间的摩擦力,传动带的张紧度可通过调节电机位置进行调整。另外传动带过紧会使传动带磨损严重,过松则易产生打滑现象,使传动带严重磨损甚至烧坏。
晶圆生产过程中,需要采用多种工艺进行处理。处理工艺多是在设备内进行。如润湿处理,需在润湿槽内进行。电镀需要在电镀槽内进行。而现有技术中,将湿晶圆放入或取出处理装置的一系列工序都需人工操作,一方面会降低生产效率,提高生产成本,另一方面也会因人工操作不当导致晶圆的损坏,降低生产合格率。同时,人工操作所需空间大,空间利用率低。人工操作的另一个弊端是劳动强度大,效率低,无法满足大规模生产的需要。人工操作还会导致工人接触电镀液或润湿液而危害工人身体健康。
有些机器具有缓冲存放系统,使工艺过程总可以有新的晶圆准备被加工(或给图形化设备的放大掩模版),从而使机器的效率大化。这些称为储料器。操作员将片匣放在机器的上载器上,按下开始键,然后的工艺过程就交给机器来做。在300mm晶圆的水平,片匣可能会被一个单的晶圆承载器或输运器所替代。
- 晶圆扶梯,晶圆扶梯,晶圆读号器,晶圆查看器
- 半导体设备
- 张先生