湖南DTS国产DTSDTS烧结银焊片
1/6
- ¥1200.00
- 2025-03-04 05:07:38
- 是
- 450℃
- DieTopSystem烧结银焊片,上海DTS,浙江DTS..
- 刘志 13611616628
- 善仁(浙江)新材料科技有限公司
信息介绍
详细参数
DTS+TCB预烧结银焊盘工艺提高功率器件通流能力和功率循环能力
在新能源汽车、5G通讯、光伏储能等终端应用的发展下,SiC/GaN等第三代半导体材料水涨船高,成为时下火爆的发展领域之一。
新型SiC芯片可用IPM、TPAK方式封装,以应用于电动车逆变器SiC导线架技术为例,导线架Copper Clip和SiC芯片连接采用烧结银AS9385连接技术,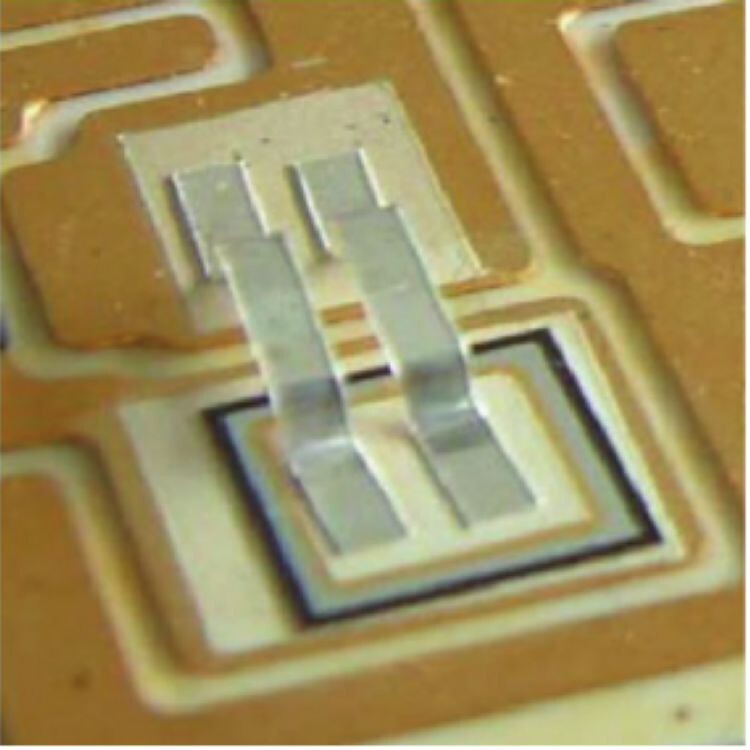
在成型技术也相当困难,由于电镀银是局部镀银,相较于全镀,部分镀银技术很难,做模具,且放置芯片处用局部银,一个导线架搭两个芯片,芯片局部银,其他引线框架用镍钯金,材料差异对引线框架制作是很大的技术挑战。
善仁新材的GVF9700无压预烧结焊盘和GVF9800有压预烧结焊盘,为客户带来多重便利,包括无需印刷、点胶或干燥,GVF预烧结银焊片工艺(DTS+TCB(Die Top System +Thick Cu Bonding)可以将铜键合线和烧结工艺很好结合在一起,同时具有较高的灵活性,可以同时让多个键合线连接在预烧结焊盘上来进行顶部连接。
GVF预烧结银焊片(DTS+TCB(Die Top System +Thick Cu Bonding))能够将电力电子模块的使用寿命延长50多倍,并确保芯片的载流容量提高50%以上。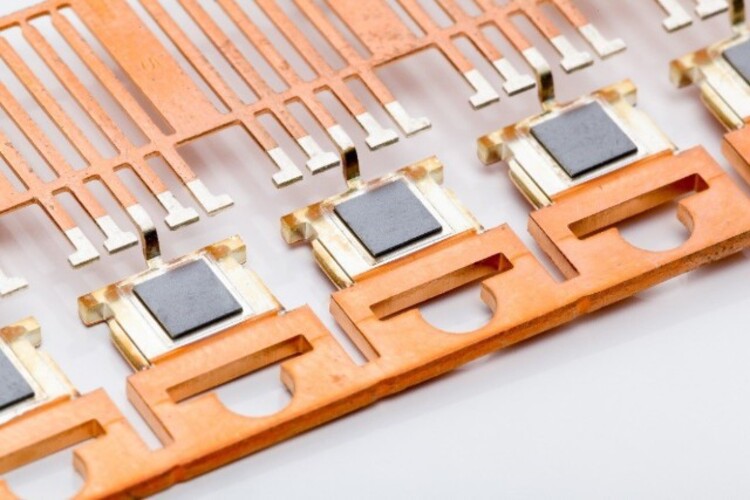
GVF预烧结银焊片(DTS+TCB(Die Top System +Thick Cu Bonding)的使用方法为:Pick & Place;
- DieTopSystem烧结银焊片,上海DTS,浙江DTS..
- 焊接材料
- 刘志
- 是
- 450℃
- 银
- 否
善仁(浙江)新材料科技有限公司为你提供的“湖南DTS国产DTSDTS烧结银焊片”详细介绍









