烧结银胶江苏烧结银深紫外LED烧结银
1/6
- ¥1300.00
- 2025-02-24 12:54:16
- 是
- 无压烧结银,中国烧结银,上海烧结银,江苏..
- 刘志 13611616628
- 善仁(浙江)新材料科技有限公司
信息介绍
详细参数
烧结银AS9378的工艺要谈到解决方案,其实就谈到了工艺。接下来给各位看一下我们烧结银所对应的工艺。善仁新材的烧结银有膏状、点涂、印刷、膜状的.
烧结产品在不同碳化硅模块等级里面的不同应用。我们把不同等级分为四大块,,芯片顶部的连接。第二,芯片的连接。第三芯片和基板的连接。第四,模块和散热器的连接。第五,晶圆级的连接。
根据芯片尺寸把焊片切割好了以后,贴到芯片顶部,后面的工艺就会非常容易实现,吸嘴把预成型的烧结银焊片GVF9880吸起来,贴到芯片顶部,在一定温度下进行压力烧结,就可以很好地解决碳化硅用现有工艺的大规模生产问题。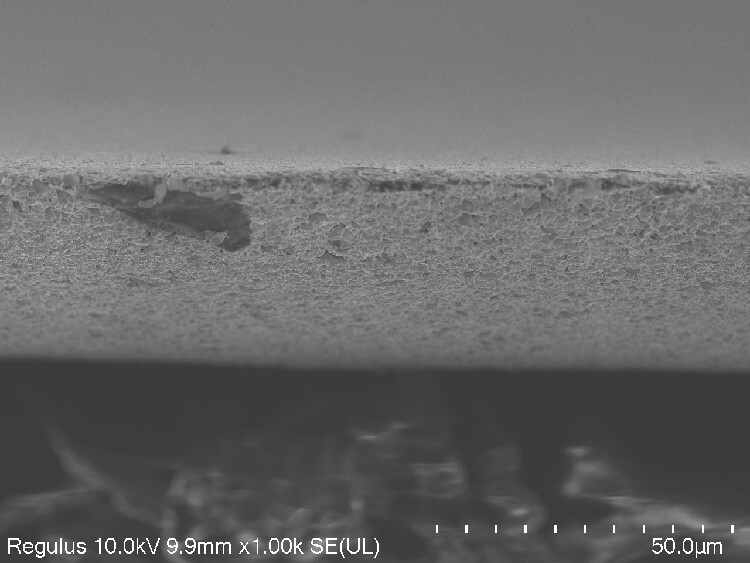
芯片和基板的连接:我们所对应的解决方案,,烧结银膏,包括点涂、印刷、喷印的,还有各种等级的银膜。在芯片和基板烧结的工艺当中,就是银膜工艺,如果以前没有做过烧结银的模块封装,可能刚开始想试试烧结银的模块,推荐采用烧结银膜的工艺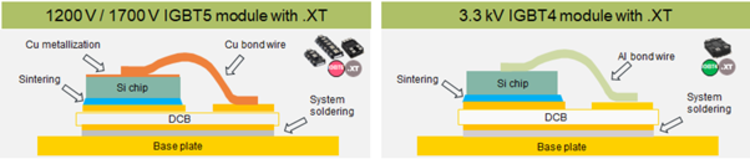
SHAREX针对现在遇到的用膜的问题,把烧结银膜GVF9500直接切割成芯片的尺寸,使用烧结银膜的效率会更高,因为不需要再做切膜工艺,膜的覆盖也会更均匀更稳定。
善仁新材能把BLT在100微米的厚度控制在10微米以内。烧结银膜AS9500具有以下特点:可以进行热帖合工艺;控制BLT;贴合后无溢出等特点;可以用于Die top attach;Spacer attach;LF attach等应用;
- 无压烧结银,中国烧结银,上海烧结银,江苏..
- 半导体材料
- 刘志
- 是
善仁(浙江)新材料科技有限公司为你提供的“烧结银胶江苏烧结银深紫外LED烧结银”详细介绍