贵州M4D9-17划片刀
- 面议
- 2025-02-25 18:54:55
- M4D9-17 划片刀 ,半导体晶圆切割刀
- 河北石家庄
- 徐发杰 18515625676
- 北京汐源科技有限公司
信息介绍
详细参数
目前,机械式金刚石切割是划片工艺的主流技术。在这种切割方式下,金刚石刀片(Diamond Blade)以每分钟3万转到4万转的高转速切割晶圆的街区部分,同时,承载着晶圆的工作台以一定的速度沿刀片与晶圆接触点的切线方向呈直线运动,切割晶圆产生的硅屑被去离子水(DI water)冲走。依能够切割晶圆的尺寸 ,目前半导体界主流的划片机分8英寸和12英寸划片机两种。
高密度的金刚石颗粒可以延长划片刀的寿命,同时也可以减少晶圆背面崩角。而低密度的金刚石颗粒可以减少正面崩角。硬的粘结材料可以更好地“固定”金刚石颗粒,因而可以提高划片刀的寿命,而软的粘结材料能够加速金刚石颗粒的“自我锋利”(Self Sharpening)效应,令金刚石颗粒保持尖锐的棱角形状,因而可以减小晶圆的正面崩角或分层,但代价是划片刀寿命的缩短。刀锋的长度应根据晶圆的厚度,承载薄膜的厚度,大允许的崩角的尺寸来进行定义,刀锋不能选得过长,因为长的刀锋会在切割时引起刀片的摆动,会导致较大的崩角。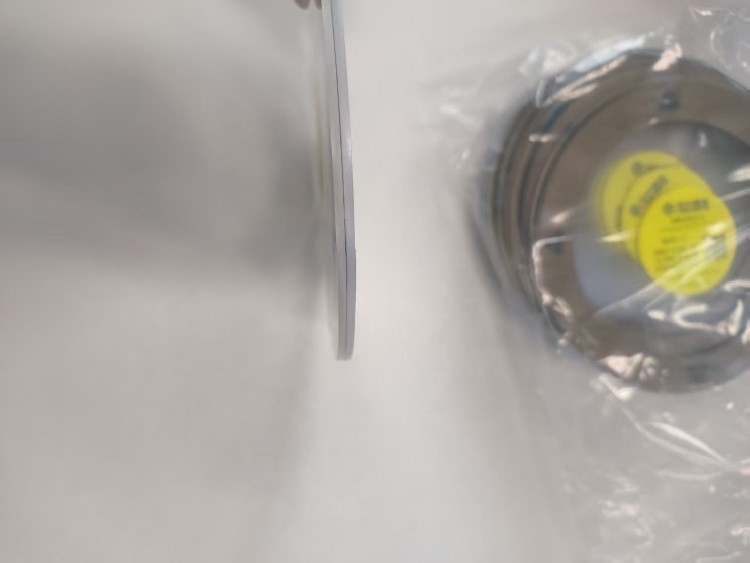
切割毛刺
毛刺在晶圆的切割边缘形成的微小的材料残留,毛刺不仅影响芯片的外观,而且对芯片的性能和后续加工步骤产生负面影响。
MEMS导电胶 绝缘胶 低应力胶2025D 84-1LMI JM7000
厚膜导电胶84-1A 84-1LMI 84-1LMIT1 JM7000 84-3 2025D
厚膜电路胶膜 506胶膜 5020胶膜 厚膜电路灌封胶 厚膜电路用胶 IGBT灌封胶
84-3J绝缘胶 芯片绝缘胶,芯片封装胶,
光纤胶,光耦胶,电路灌封胶,传感器灌封胶,电源灌封胶,乐泰UF3808底部填充胶 底部填充剂 微波器件导电胶,低应力底部填充胶,高导热灌封胶,BGA底部填充剂,BGA导热胶,DAF膜,
Ablestik光通信器件胶,高透光UV胶,光纤尾胶,光纤头胶,通过双85测试,耐低温-65度。
- M4D9-17 划片刀 ,半导体晶圆切割刀
- 螺纹胶
- 河北石家庄
- 徐发杰



