新疆硅晶碇切片胶蓝宝石,单晶硅切片胶
- 面议
- 2025-02-02 06:14:39
- 硅晶碇切片胶,晶碇切片胶,碳化硅切片胶,..
- 广东深圳
- 徐发杰 18515625676
- 北京汐源科技有限公司
信息介绍
详细参数
电镀铜填充设备
很多成本模型显示,TSV填充⼯艺是整个⼯艺流程中昂贵的步骤之⼀。 TSV
的主要成品率损耗之⼀是未填满的空洞。电镀铜⼯艺作为合适的硅 通孔填充
技术受到业内的普遍关注,其关键技术在于TSV⾼深宽比(通常 ⼤于10:1)通孔的
全填充电镀技术。
玻璃通孔⾼密度布线
线路转移(CTT)和光敏介质嵌⼊法,是比较常用的⽅式。 CTT主要 包括两个过
程。⼀是精细RDL线预制,每⼀RDL层可以在可移动载体上单 制造⼀层薄导
电层,并在转移到基板上之前测试或检查细线成品率。精 细线路的形成采用细
线光刻和电解镀铜的⽅法,并且以薄铜箔作为镀层的 种⼦层
国内外研究现状
2011年,瑞⼠的微纳系统研究部提出了如下图所示的基于TSV技术圆片级 真空
封装⽅案。该⽅案由TSV封帽与器件层两部分构成,TSV封帽垂直导 通柱是填
充在硅通孔中的铜柱。器件层上制作有⾦锡电极与铜柱相连,从 ⽽把电信号从
空腔内部的引到空腔外部,后通过硅-硅直接键合实现密 封。该⽅案⽓密性
很好,但是TSV封帽制作⼯艺复杂,热应⼒⼤(铜柱与 硅热失配⼤),且硅硅键
合对键合表面要求质量很⾼,⼀般加⼯过的硅片 很难达到此要求。
- 硅晶碇切片胶,晶碇切片胶,碳化硅切片胶,..
- 蚀刻机
- 广东深圳
- 徐发杰
北京汐源科技有限公司为你提供的“新疆硅晶碇切片胶蓝宝石,单晶硅切片胶”详细介绍
推荐信息
-
 宁河烧结银纳米银导电胶ssp2020设备,烧结银
宁河烧结银纳米银导电胶ssp2020设备,烧结银 -
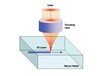 湾泰晶圆临时键合水解材料,北京湾泰晶圆临时键合解键合材料芯片
湾泰晶圆临时键合水解材料,北京湾泰晶圆临时键合解键合材料芯片 -
 乐泰LOCTITE乐泰F131,芯片金属封装
乐泰LOCTITE乐泰F131,芯片金属封装 -
 汉高JM7000导电胶,汉沽高导热汉高ABLESTIKJM7000导电胶
汉高JM7000导电胶,汉沽高导热汉高ABLESTIKJM7000导电胶